
한양대학교 신소재공학부 박진성 교수 연구팀은 산화물 반도체(In₂O₃)를 대상으로 원자층 증착(Atomic Layer Deposition, ALD)과 원자층 식각(Atomic Layer Etching, ALE)을 결합해, 두께 수 나노미터 수준에서도 결정성을 유지하면서 전기적 특성을 향상시킬 수 있는 신규 원자층 공정(Atomic Layer Processing, ALP)을 개발했다고, 26일 밝혔다.
연구팀은 수소 플라즈마를 이용한 표면 환원 단계와 유기 리간드(아세틸아세톤, Hacac)를 이용한 제거 단계를 순차적으로 결합해 결정성 보존형 In₂O₃ 원자층 식각 공정을 구현했다. 이를 ALD로 성장시킨 산화물 채널에 적용해 정밀 etch-back을 수행한 결과, 두께 3 nm 초박막에서도 (222) 우선 배향이 유지됐으며, 표면 거칠기는 0.27 nm에서 0.17 nm로 감소하는 등 결정성 및 표면 품질을 동시에 확보하는 데 성공했다.
특히 연구팀이 동일 두께(3 nm)의 In₂O₃ 채널을 비교 분석한 결과, ALD-only 공정에서는 결정성이 거의 형성되지 않고 이동도(~2 cm²/V·s)가 낮으며 문턱전압 불안정성(ΔVTH ≈ −5.5 V)이 크게 나타난 반면, ALD–ALE 결합 공정에서는 정렬된 결정립과 큰 결정립 크기가 유지되며 이동도(약 12 cm²/V·s)가 크게 향상되고 ΔVTH 역시 −0.75 V 수준으로 개선된 것으로 확인됐다.
이는 기존 ALD 공정이 가진 ‘임계 두께(critical thickness) 이하에서 결정성 확보가 어려운 한계’를 ALD–ALE 연속 공정으로 극복한 것으로, 초박막 환경에서도 결함 밀도를 억제하고 우수한 전기적 신뢰성을 구현할 수 있는 새로운 공정 패러다임을 제시한다.
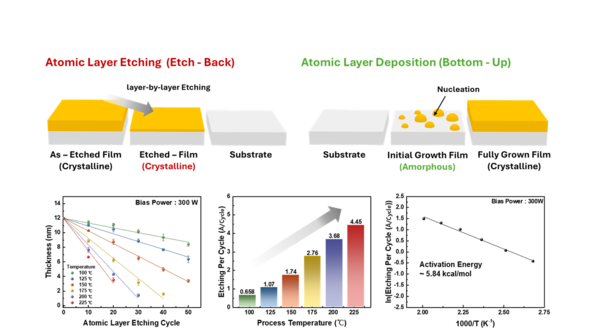
박진성 교수는 “이번 연구는 산화물 반도체 채널에 ALD와 ALE를 연속 적용하는 원자층 공정(Atomic Layer Processing)의 가능성을 실험적으로 입증했다는 점에서 의미가 크다”며 “향후 3D DRAM·3D NAND 등 차세대 메모리, BEOL(백엔드 호환) 로직 소자, 고해상도 디스플레이용 산화물 소자 등에서 3 nm 이하 초박막 채널을 안정적으로 구현하는 핵심 기반 기술이 될 것”이라고 밝혔다.
또한 박 교수는 “플라즈마 식각이나 반응성 이온 식각(RIE)에 비해 ALE는 자기제한적(layer-by-layer) 반응을 통해 손상을 최소화하면서 두께·조성을 정밀 제어할 수 있는 장점이 있다”며, “이번에 확보한 결정성 보존 ALE 공정은 IGZO, IGO 등 다양한 산화물 반도체 및 고유전 절연막으로 확장 가능해, 미래 반도체 신소자 설계의 플랫폼 공정으로 발전할 것”이라고 전망했다.
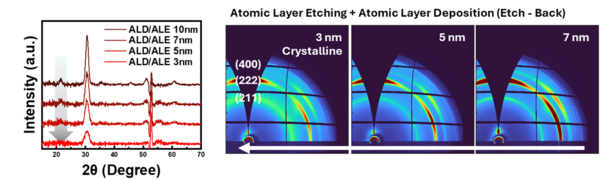
이번 연구는 한국연구재단 혁신연구선도센터(IRC) 사업의 지원을 받아 수행됐으며, 연구 결과는 나노소자·나노공정 분야의 국제 저명 학술지 『ACS Nano』 11월호에 온라인 게재됐다.
해당 논문 「Crystallinity-Preserving Atomic Layer Etching of Ultrathin In₂O₃ for Stable Oxide Nanoelectronics」에는 한양대 신소재공학부 김민찬 석박통합과정이 제1저자로, 박진성 교수가 교신저자로 참여했다.


 '한양위키' 키워드 보기
'한양위키' 키워드 보기